國產EDA扎堆亮相,異構集成刷屏熱議 世界半導體大會的集成電路設計風向標
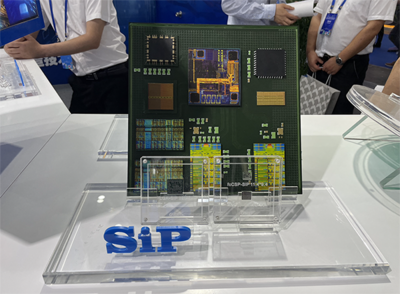
世界半導體大會的集成電路設計專題論壇成為了全球產業與技術關注的焦點。兩大核心趨勢——國產EDA(電子設計自動化)工具的集中突破與異構集成的技術深化,構成了本次盛會的技術主旋律,深刻揭示了后摩爾時代芯片設計領域的關鍵演進路徑。
國產EDA:從“點工具”到“全流程”,生態突圍進行時
本屆大會上,多家國內領先的EDA企業集中展示了最新研發成果,覆蓋了從模擬電路設計、數字前端到后端物理實現、封裝仿真乃至芯片制造良率提升等多個環節。與以往在個別“點工具”上取得突破不同,當前的展示更強調全流程解決方案的整合能力與對先進工藝節點的支持。
核心亮點包括:
1. 全流程工具鏈雛形顯現: 部分國產EDA平臺已能夠支撐特定領域的完整設計流程,例如在模擬/數模混合電路設計或特定工藝的物理設計方面,提供了從前端設計、仿真驗證到版圖生成的一體化工具集,顯著降低了設計門檻和工具切換成本。
2. 與先進工藝和封裝協同: 新一代工具加強了對FinFET等先進工藝的適配,并開始深度集成面向Chiplet(芯粒)和異構集成的設計、仿真與驗證模塊,體現了從跟隨到面向未來需求的轉變。
3. 產學研用協同深化: 大會期間,多家EDA公司與頭部芯片設計企業、晶圓廠及高校簽署了深度合作協議,旨在通過實際項目打磨工具,加速迭代,共同構建更健壯的國產EDA應用生態。
業界共識認為,國產EDA正從“可用”向“好用、易用”階段邁進,但挑戰依然存在,包括在超大規模數字電路設計、尖端工藝PDK(工藝設計套件)的完整支持以及與全球最復雜IP生態的深度融合等方面,仍需持續攻堅。
異構集成:超越摩爾定律的“C位”技術
如果說EDA是設計之“筆”,那么異構集成則代表了設計思想之“魂”。本次大會上,異構集成技術占據了技術討論的絕對“C位”,成為應對算力需求爆炸、功能多樣化與能效挑戰的核心答案。
討論焦點集中在以下幾個方面:
1. Chiplet(芯粒)互連與標準: 如何實現不同工藝節點、不同功能、不同來源(甚至不同廠商)的Chiplet之間的高速、高帶寬、低功耗互連,是技術關鍵。大會深入探討了UCIe(通用芯粒互連技術)等新興開放標準的進展、挑戰與生態建設路徑。國內產業界也在積極推動相關標準的研究與制定。
2. 先進封裝技術驅動: 異構集成的實現高度依賴于2.5D/3D封裝、硅通孔(TSV)、扇出型(Fan-Out)等先進封裝技術。封裝廠與設計公司的協同設計(Co-Design)成為必然趨勢,EDA工具需要為此提供從架構探索、物理實現到熱、應力、信號完整性分析的全面支持。
3. 系統級架構創新: 異構集成不僅僅是物理上的堆疊,更是系統架構的革新。設計思路從單一SoC(系統級芯片)轉向基于芯粒的“樂高式”系統級封裝(SiP),如何在不同計算單元(CPU、GPU、NPU、FPGA等)之間實現高效的存算一體、數據調度與任務分配,是提升整體系統性能的關鍵。
4. 設計方法論變革: 傳統的芯片設計流程正被重構。系統架構師、芯片設計師、封裝工程師、軟件開發者需要更早、更緊密地協作。新的設計工具鏈和驗證方法學(如芯片-封裝-系統協同仿真)亟待完善。
融合與展望:設計、工具與生態的共舞
世界半導體大會清晰地表明,集成電路設計的是國產EDA工具的自主創新與異構集成的系統級突破兩條主線深度融合、相互促進的進程。
- EDA工具必須擁抱異構集成的復雜性,發展出能夠處理多物理域、多尺度、多工藝協同設計與分析的下一代平臺。
- 異構集成技術的廣泛應用與成本降低,反過來也離不開強大、靈活且成本可控的EDA工具支持。
- 開放合作的產業生態是成敗的關鍵。從芯粒接口標準、IP復用、到設計與制造服務的協同,構建一個全球或區域性的、基于開放標準的異構集成生態系統,將是整個產業面臨的共同課題。
結論: 本屆世界半導體大會為集成電路設計領域描繪了一幅清晰的圖景:在后摩爾時代,通過國產EDA的全流程攻堅與異構集成的系統級創新“雙輪驅動”,中國集成電路產業正致力于在基礎工具和前沿設計方法學上構建核心競爭力,以期在全球半導體產業的新一輪格局重塑中占據更主動的位置。前路挑戰艱巨,但方向已然明確,步伐正在加速。
如若轉載,請注明出處:http://m.aozhang.cn/product/59.html
更新時間:2026-01-06 13:37:08